PCB电路板制作(一)遭遇强热
一、模拟回焊
通常电路板制作后下游的PCBA组装流程约有4次受热的经历,即:
(1)正面印刷锡膏及点胶并热风回焊。
(2)反面经翻面后再次进行锡膏回焊。
(3)插脚零件进行波焊。
(4)可能再经1-2次之重工补焊等。
因而组装业者多半要求PCB厂家的空板,也要按特定的回焊曲线模拟五次以上的回焊,做为是否可耐强热的出货参考标淮。
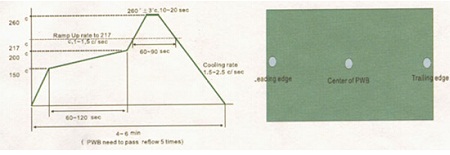
图1、左图为美商IBM针对无铅焊接空板考试用的回焊曲线,右为板面感测热偶线焊牢的三个位置。考试板一共要经过5次试焊,不可出现任何爆板与起泡等缺点时,该空板才算及格。
事实上即使空白多层板能够通过五次模拟回焊的考验,也难以保証组装者在回焊作业上的安全无羔,仍然会在实装中出现某些比率的爆板。主要原因是板面上多了零组件的额外应力影响所致。
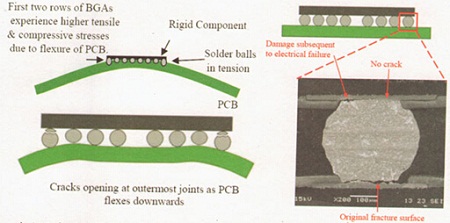
图2、左上及左下两图均说明,回焊中的上风温度要比下风高出约50-60℃,由于热胀不均使得PCB会出现隆起状态,进而对形成拉伸应力,以致最角落的球脚銲点呈现应力危机,右图即为回焊后已拉裂的眞相。
热风回焊炉的上风通常会比板面的下风高出约50-60℃,下风的目的只是在维持板体的基本热量,根本无需与上风保持同热,如此将可避免不必要的能源浪费与对板材的伤害。而且当翻面二次回焊时,还可减少对第一面已焊妥者的强热伤害与可能掉件。然而此等上下板面热量的不同,也必然会导致PCB两面热胀的差异,在回焊中出现板面轻度驼背式的弧形隆起,进而引发致密装零组与PCB之间的拉扯应力。尤其当回焊温度与时间所积分而得到的庞大热量,不但早已远远超板材的Tg ,早已让板材从低于Tg的α-1玻璃态, 转变为Tg以上α-2的柔软橡胶态,此时一旦又出现颇多局部应力的作用下,造成厚多层板从表层发生的起泡与迸裂。

图3、回焊中的PCB早已超过Tg进入软弱的α-2的橡胶态,一旦所贴装零件的CTE与PCB的Z-XTE相差很大,则其拉扯应力经常会将銲点或板体两者局部拉裂。
二、板材橡膝态的软弱
凡当板面装有多颗大型BGA或QFN前寺,由于其等封装载板内部之晶片〈芯片),所呈现的热胀率(CTE)只有3-4ppm/℃ ,因而会迫使X与Y轴热胀率15ppm/℃的载板,回焊中不得不朝上被拉起而凹翘。此等载板之朝上翘起与PCB母板之向下弯曲,背道而驰相互拉扯下必然会伤及銲点与胀裂板材。曾有一种对板材的不成文加热原则,那就是每升温10℃时其树脂将加倍获取反应的能量,而且热风回焊过程中体积与质量均属最大的?其所受热的程度也远高于板面的各种零组件。
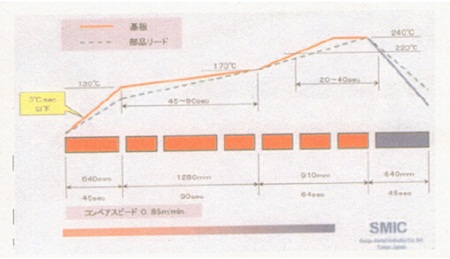
图4、此为日本千住金属9热2式之回焊曲线,可见到多层板之受热要超过零组件,此即爆板隐忧之所在。
上图即为著名日本銲料供应商千住金属所提供的无铅回焊曲线,说明板材与零组件受热的比较。由此图可知,超过Tg170℃以上的时间竟达85秒之多,使得处于橡胶态的板材早已变得软弱不堪,只要少许局部外来的力量即将造成Z方向板材的迸裂。手机板若採背胶铜箔RCC增层者,其可逃过此劫之机会的确不多。
事实上FR-4板材处于Tg以下的α1玻璃态时,其Z轴的CTE即已多达55-60ppm/℃,并远超过有玻纤布所箝制X与Y方向的14-15pm/℃甚多。一旦进入α2橡胶态时,其Z轴的CTE更高达250pm/℃以上,任何局部不平行于板面的应力,都有可能造成外层的起泡或胀裂。
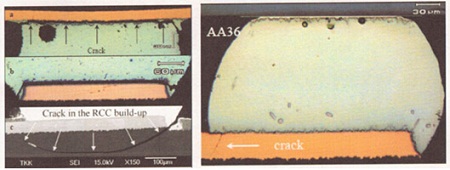
图5、左图为回焊中由于元器件之应力而造成球脚銲点的断头,断脚甚至连多层板也从RCC胶层中强力开裂,右图中还可见到BGA球脚竟然把PCB上的铜垫也拉断的眞相。

图6、此为JEDEC协会针对封装元件耐热性之考试曲线,其中绿色者为无铅焊接所用者,橘色者为有铅曲线。可见到两曲线下含面积(即热量)相差之大了。事实上对一般板子无铅焊接而言,这条曲线还是太烫了 ,可视情沉而向下修正。
三、容易爆板的位置与原因
(一)、内层大铜面区域
由于铜材(CTE仅17pm/℃)与树脂Z方向的热胀系数(CTE)相差太远,因而大铜面区在强大热量(指温度对时间的积分)中很容易爆板。解决的办法是刻意在大铜面区,佈局少许无功能的通孔当成铆钉用,不但能够协助散热还可减少多层厚板的爆板灾难。然而前题是PTH孔铜的品质一定要够好,其延伸率应控制在20%以上才有意义。事实上由于目前电镀铜製程的长足进步,使得优良药水供应商在镀铜层延伸率方面早已超过30%而非难事。现行背板业者与下游客户最新协商的结果,暂定以18%为製程之下限,将来在无铅回焊盛行的压力下,迟早一定会攀升到20%的起码规格。

图7、对高多层而言,其大铜面区的各内层就很容易发生多处爆板(见左图),但若通孔镀铜的延伸率良好时(例如20%以上),即将发挥铆钉作用而减少爆板(见中图),否则即使层数较少厚度较薄的大铜面区仍可能出现多处爆
话虽如此,然而仍有很多二线三线的镀铜製程供应商,其品质尚远远落后现行厚板要求的18% ,其至连一般多层板所要求的15%也到不了。当然PCB现场镀铜槽液的管理与孔铜品质的检查,也都不可马虎,以减少无铅回焊中板材的胀裂。
一旦发生大铜面区的爆板,很多人直觉反应就内层的黑棕化皮膜不良,附著力不足所致。然而当微切片製做精美,且在裂沟中又做了二次塡胶与进一步细磨者,其开裂是否从铜箔的黑化层所引发,即可一清二楚根本无需浪费口舌了。

图8、此为14层达2.5mm的多层板,其中一枚经由绿漆塞孔无需填锡的深孔,经波焊后发生无法导通的断孔切片断(50x),以及局部拉断之细部情形(500x)。虽然板材己出现纹,但主要原因还是电镀铜品质不佳。
(二)、通孔密集区
例如大型BGA的腹底密脚区,其球垫与内层互连的众多密集通孔,回焊前若未加堵塞时,则下风大量热能的趁虚而入,造成上下热量交加又难以散热之下,加倍煎熬中当然就很容易出现局部爆板,甚至连^八球脚焊点也会出现过热问题。且当板子翻面进行二次回焊时,还可能会造成先前銲点的再熔或强度的减弱。至于多针脚之连接器,不管是採用传统波焊,或PIH的鍚膏进孔回焊,都会带来额外的应力而容易爆板,亦为相当棘手的问题。
然而完工板欲对此等通孔採用绿漆堵塞以隔绝热风时,可谓工程艰巨困难重重,任谁也没有把握彻底塞满而毫无破绽。至于改用良好品质的特定树脂塡塞者,其成本之昂贵又非一般电路板厂家所能负担。堵塞不牢的通孔其后续銲垫之溼式表面处理中,将难以杜绝药液的渗入。甚至喷锡过程中还可能发生锡渣被挤入而形成内藏等烦恼。任何PCB流程的瑕疵,都将会造成后续致命的伤害。

图9、此二图均为无铅焊接BGA腹底球垫的佈局情形,左图可焊面积较大者为小型CSP所用,右图为一般常规BGA所用。两者绿漆均未上垫均属NSMD〈非绿漆设限)之设计,因而印刷锡膏的钢板开口也应採Overprint (开口比垫面还大)的理念才对。
至于连接器的多脚插装区,虽然也是多孔密孔地带,但由于泰半是採用单面暂短强热的波焊或选焊〈强热时间只有4-5秒钟而已),其灾难与痛苦远不及热风回焊"熔点以上历时"长达90秒的可怕。加以零件脚本身也能协助吸热散热,因而爆板机率也可为之降低。

图10、左图为新式HDI设计之BGA球垫,是以微盲孔直接与内层互连。中图为传统式球垫,仍以PTH全通孔与内层进行互连,使得板面佈局显得非常拥挤,而且无铅焊接也容易爆板。右图为焊后容易断头的画面。
(三)、外层局部起泡
多层板早已跳脱一次性的传统压合法,不管是採用RCC或胶片的增层,或非HDI逐次压合的高阶多层板类,在回焊中其外贴层次受热的速率与热量,自必超过内在的核心板甚多。故一旦下游组装者的回焊炉不够理想,或其回焊曲线仍然延续老旧不当的有铅做法,甚至对于无铅回焊之缓升温、长吸热、与平顶峰温之全新观念毫无所悉者,势必将因组装者的无知, 而造成为数可观的冤枉爆板。
一般PCB业者对下游之回焊原理较少深入,而组装业者普遍对无铅回焊的可怕不但所知有限瞭解太少,而且一向站在买方立场的强势心态,一旦爆板则必定怪罪PCB厂。于是割地赔款无过认错的镜头也就不断上演了!此等局部外层起泡以大型BGA或QFN附近之板面居多,尤以后者之低矮无脚QFN最容易出问题。至于内层PTH的埋孔孔环附近,其于外层压合之前是否做过良好的黑氧化处理?即使做过却又因孔环面积太少抓地力不足下,是否能顺利闯关?亦为问题之所在。其他板边板角等通孔密集地带也是高危险区,热量太大时出问题的机率也不在少数。
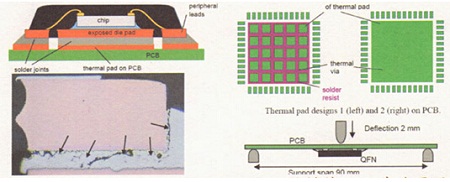
图11、左上图及右上图分别为QFN的侧视及俯视结构情形,其外围焊垫由于强热中亳无缓衝的馀地致使板材及銲点都容易拉裂,故中央区域刻意加设只有散热用的大铜垫,以加强元件整体性的强度。但却会对PCB造成爆板,左下及右下图为銲点强度被拉裂,及其试验过程的说明。
(四)、多次强热造成多处爆板
无铅焊接的PCB仍将延续先前的做法,仍以双面SMT锡膏回焊为主,外加一次输送波焊或局部选择性涌焊。倘若PCB的銲垫表面处理是採用无铅喷锡者,等于又多了一次波焊。如此3-4次之强热折磨下,多层板早已经岌岌可危安全不保。一旦板子放置太久以致应力能量之累积,或压合后未做后烘烤以消除应力者,则板材成员(玻纤、树脂、铜层)等彼此间CTE的差异,将逐渐浮出而出现释放应力的行为,或完工板又已吸入水份时则更是雪上加霜;一旦获致强热而得以舒发与气化的机会,当然就各自展露本性对结合力造成瞬间的伤害了。此刻若于回焊前能够执行妥善的烘烤,则可减少爆板的发生。
凡经上述三次常规焊接之外尚有其他强热者,例如利用回焊或波焊进行补焊,或更换主动元件之重工修焊者,都有可能造成爆板,业者不可不小心处理。根据生产线长期的经验可知,无铅回焊对多层板的伤害,约等于无铅波焊的2-3 次以上,故一旦发现某些局部焊接瑕庇时,应儘量以手焊的做法,取代原本大动作再次上线的回焊与波焊。

图12、此二图均为电流用的厚铜多层板,经无铅焊接一次即爆的切片图,主因是板材的树脂系统不耐强热长时间的折磨,下游组装的回焊曲线也有问题。
| 我要评论: | |
| 内 容: |
(内容最多500个汉字,1000个字符) |
| 验证码: | 看不清?! |
最新产品
同类文章排行
- 【科普】检查和避免电路板短路的方法都有哪些?
- PCB厂讲电源电路中,电感底部需要铺地吗?
- 汽车无线充电PCB厂讲IPC2级和3级标准的差异对比
- 电路板厂家FPC软板和PCB电路板有哪些区别?
- 汽车电路板厂讲如何区别化镍钯金与电镀镍金?
- PCB板叠层当中的“假八层”是什么意思呢?
- 电路板厂之10种PCB散热方法解析
- 5G天线PCB厂讲PCB电路板的IPC等级到底是什么?
- 线路板厂讲设计PCB都有哪些间距要求?
- 线路板如何影响汽车的性能、效率和安全性?
最新资讯文章
您的浏览历史










共有-条评论【我要评论】